突破氧化與焊接的雙重考驗:深度解析電路板表面處理製程與耐用度
從材料化學與物理特性角度,解析鍍金與沉金製程的差異,協助研發與採購團隊在面對高密度封裝與大電流應用時,精準選擇最合適的表面工藝。
- 鍍金電路板
- 沉金電路板
- 厚銅電路板
- 電路板製造
- PCB電路板製造
為什麼表面處理是決定組裝良率的關鍵防線?
在精密電子產品的硬體架構中,裸露的銅箔雖是絕佳的導電載體,卻在物理化學特性上具有極強的親氧性。只要暴露在空氣中吸收微量濕氣,銅面便會迅速生成一層氧化銅薄膜,直接阻斷 SMT 迴焊過程中錫膏與銅墊的冶金反應,導致嚴重的拒焊、空焊或焊點剝離。
為確保電子零件能牢固地貼裝於電路板上,所有的 電路板製造 流程在防焊綠漆工藝之後,都必須經歷最後一道防線:表面處理。其核心工程目的,是暫時或永久性地將銅面與空氣隔離,同時提供一個有利於無鉛錫膏擴散的優質基底。面對消費性電子、車用模組或伺服器等不同應用場景,研發與採購人員必須深入理解不同金屬皮膜的微觀結構,才能在成本與可靠度之間找到最佳平衡點。
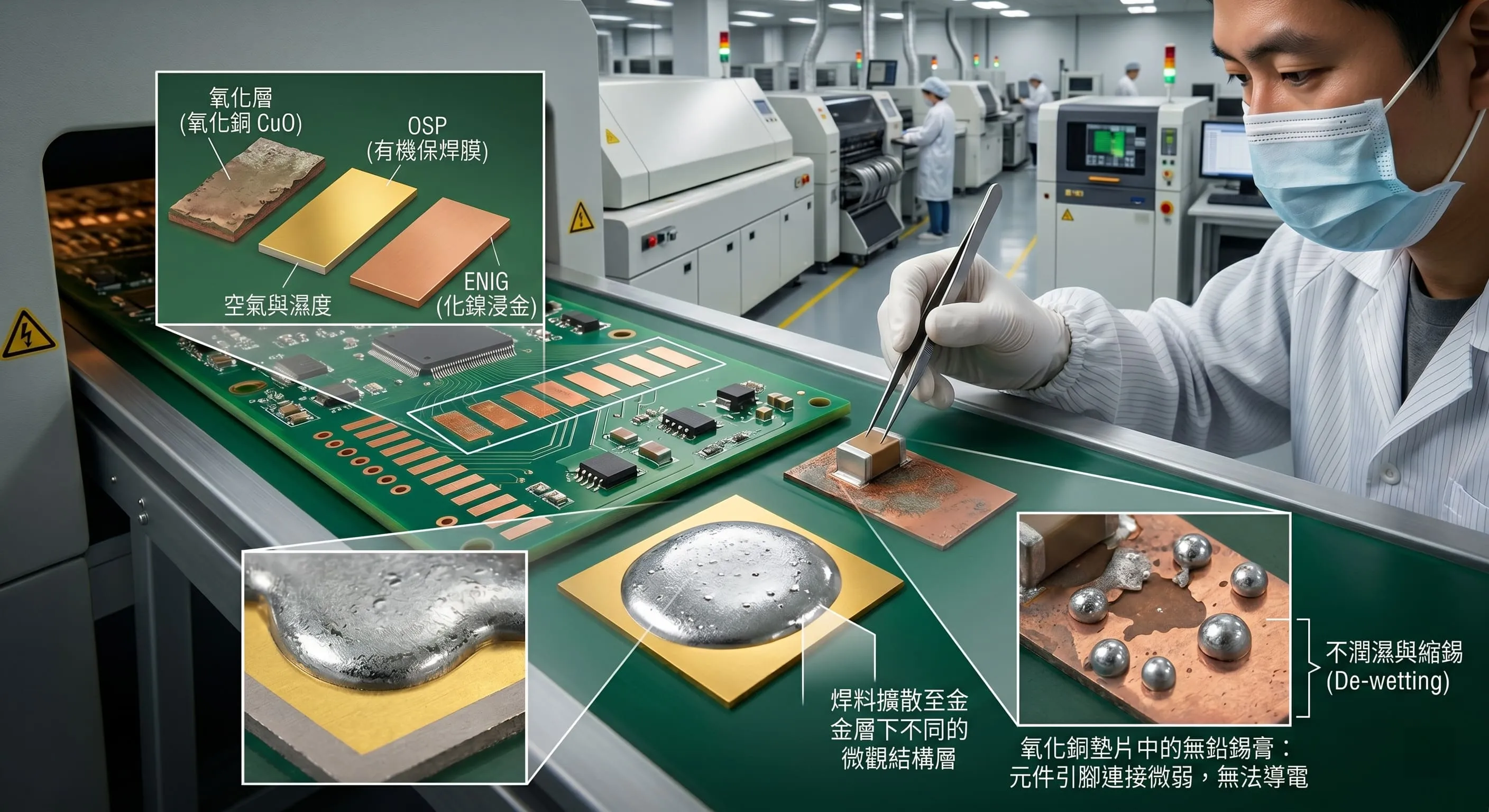
沉金製程的化學反應機制與平整度優勢
目前高階智慧型手機、通訊模組與醫療設備中最主流的表面處理方案,莫過於化學鎳金,業界通稱為 沉金電路板。這是一項純粹依賴化學氧化還原反應的無電鍍工藝。
ENIG 的製程分為兩個核心階段:首先在乾淨的銅墊上化學沉積一層厚度約 118 至 197 μin的鎳磷合金層,接著利用置換反應於鎳層表面覆蓋一層極薄的純金。這層純金的唯一作用是「防氧化」,能在長達半年至一年的庫存期內,保護下方的鎳層不被空氣侵蝕。
當板材進入 SMT 高溫迴焊爐時,表面的純金瞬間溶解進入液態錫中,真正的焊接主角其實是下方的「鎳層」。錫與鎳產生冶金反應,生成緻密且強韌的 Ni₃Sn₄ 介金屬化合物。沉金電路板 最大的物理優勢在於其完美的表面平整度。化學沉積的特性使每一處焊盤上的厚度高度均勻,對於腳距極微小的 BGA 封裝或 CSP 晶片而言,能徹底消除因表面高低落差引發的元件立碑或吃錫不均問題。
電鍍金工藝的物理極限與耐磨耗霸主地位
雖然 ENIG 具備極佳的平整度,但其表層的純金極度柔軟,無法承受高頻率的物理摩擦。面對需要多次插拔的記憶體模組金手指、遊戲機卡匣或工業控制用的觸控按鍵區,必須導入電鍍金工藝,這類產品即為 鍍金電路板。
電鍍金屬於電解反應,須透過導電線路引入外部電流使金離子附著。為大幅提升金層的硬度與耐磨耗性,電鍍液中會刻意摻入微量的鈷或鎳元素,形成硬金合金,厚度可依插拔次數需求彈性設定在 30 μin 甚至高達 50 μin 以上。這種厚度的硬金層能輕易承受上萬次機械摩擦而不露出底層銅箔。
研發設計端必須嚴格拿捏金層厚度。若將電鍍厚金直接應用於大面積的 SMT 焊接區,迴焊時過量的金元素大量溶入焊錫中,冷卻後會形成脆性的 AuSn₄ 介金屬化合物,此現象即「金脆」,導致焊點在遭受震動或熱應力衝擊時輕易斷裂。針對焊接區,鍍金電路板 通常採用軟金或搭配局部鍍金的遮蔽技術來規避此風險。
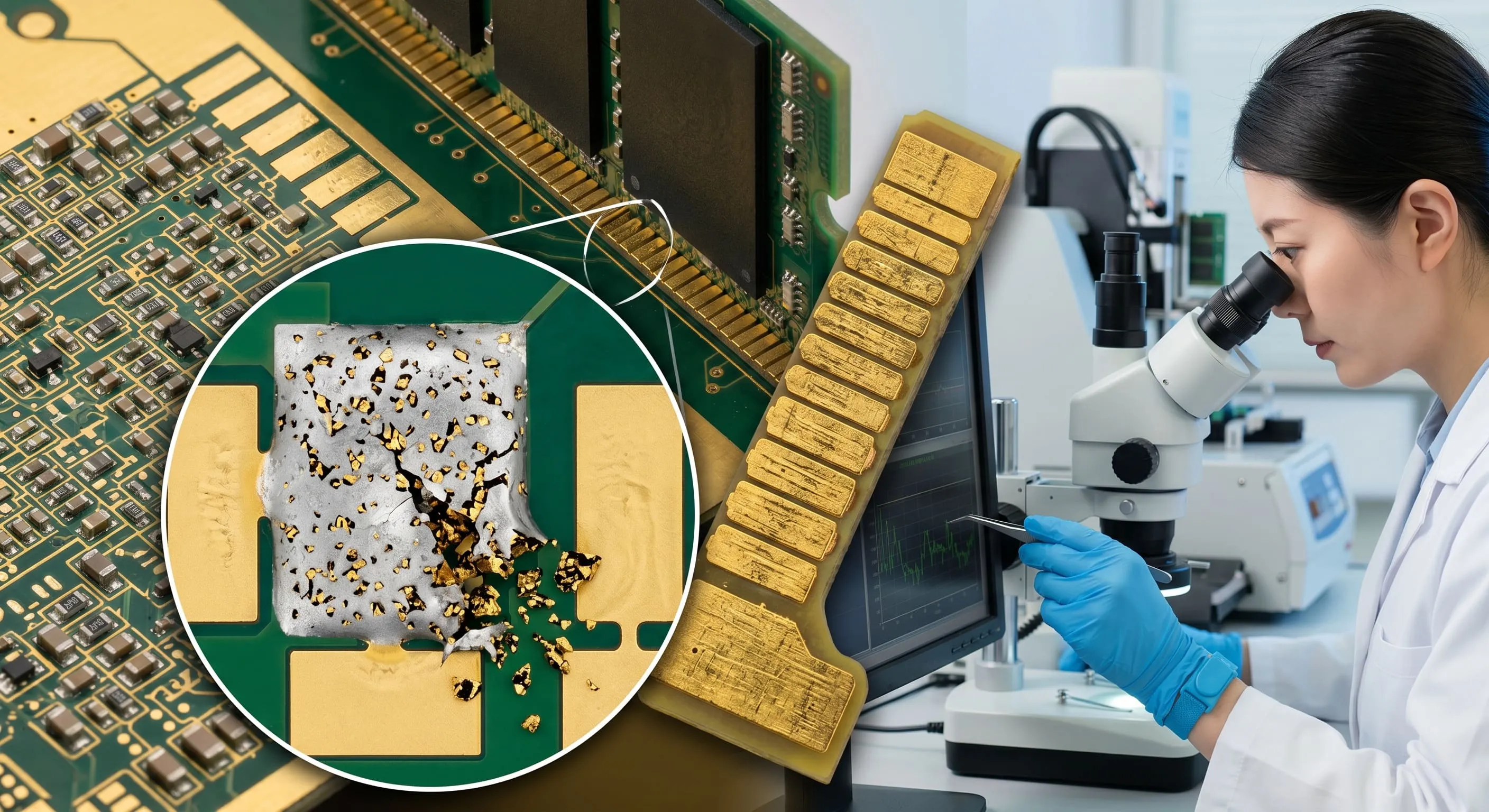
當大電流遇上抗氧化:厚銅基材的表面工藝挑戰
隨著電動車、太陽能逆變器與高功率電源供應器的蓬勃發展,電路板需要承載數十安培以上的強大電流。常規的 1oz 銅箔已不敷使用,取而代之的是 3oz、6oz 甚至 10oz 以上的 厚銅電路板。當基材厚度與銅重呈倍數增長時,表面處理的化學流體力學也將面臨嚴苛挑戰。
在進行 厚銅電路板 的表面處理時,巨大的線路高低落差容易導致藥水在溝槽內滯留或產生氣泡。若採用 ENIG 製程,鎳缸與金缸的藥液若無法均勻交換,極易在深谷處發生漏鍍或皮膜厚度不均的缺陷。高階的 PCB電路板製造 廠房會引進強力的超音波震盪設備與特殊的水平噴流設計,強制更新微小縫隙內的化學藥水,確保最厚重的銅線路也能獲得緻密、無死角的抗氧化保護層,為大功率模組提供最安穩的熱傳導與焊接基底。
採購決策矩陣:如何評估最適合的表面處理?
從供應鏈管理的角度切入,選擇表面處理不僅是技術規格的探討,更是成本結構與產品生命週期的綜合評估。在眾多 PCB電路板製造 工藝中,採購人員可依循以下決策邏輯進行判斷。
若產品屬於消費性電子、生命週期短且無細間距元件,OSP是成本最低的選擇,但保存期限極短且無法承受多次迴焊。若產品涉及高密度 BGA 封裝、需要長達數月的海運庫存期,且終端應用於醫療或網通等高可靠度領域,成本較高但良率極穩定的 沉金電路板 絕對是首選。面對極端環境操作或需要頻繁物理插拔的工業機台,將預算投入於抗磨損的 鍍金電路板,能大幅節省後期的設備維修與客訴成本。精準對齊產品的應用場景,才能發揮每一分製造成本的最大效益。

FAQ
Q1:研發端在設計高頻通訊模組時,應該選擇沉金還是鍍金?
A1:高頻訊號傳輸具有強烈的「集膚效應」,訊號會集中在導體的最表層流動。沉金電路板的結構中含有較厚的鎳層,而鎳屬於鐵磁性金屬,會對高頻微波訊號產生顯著的電阻損耗與干擾。針對此類高頻應用,建議採用化學沉銀、OSP 或高階的化學沉鈀金製程。若必須使用金層防護,極薄的化學純金能將訊號損耗降至最低,傳統電鍍硬金與含鎳沉金則應盡量避免佈局於射頻走線區域。
Q2:SMT 組裝廠常反映焊點強度不足甚至發生「金脆」,這與表面處理的厚度有關嗎?
A2:完全相關。「金脆」現象主要發生在 鍍金電路板 或金層厚度管控失常的沉金板上。當金層厚度超過 3 μin 時,焊接過程中過量的金溶入錫膏,冷卻後形成片狀的 AuSn₄ 晶體。這種介金屬化合物的物理性質極度脆弱,當電路板受到微小的機械彎折或熱脹冷縮應力時,焊點便會從內部沿著 AuSn₄ 結晶面斷裂。因此,嚴格要求 PCB電路板製造 端將金厚控制在 1 至 2 μin,是防範此問題的核心對策。
Q3:針對大電流的電源供應器,厚銅板在做化學鎳金表面處理時,最容易發生什麼客訴風險?
A3:厚銅電路板 最大的風險在於「黑墊」效應的放大。由於厚銅板的熱容量巨大,在化學鍍鎳階段,若藥水活性控制不佳或磷含量失衡,後續在金槽進行置換反應時,金離子會過度攻擊並腐蝕底層鎳層結構,導致鎳層氧化變黑。這種黑墊缺陷會造成嚴重的拒焊或假焊,元件看似貼附實則一碰即掉。解決之道在於製造廠必須具備高階的藥水監控儀器,精準控制鎳槽的酸鹼值與溫度,並優化金槽的置換速率,以確保重載銅面的皮膜品質達標。


